钴化学机械抛光(CMP)的技术研究
当技术节点降低至32 nm 及以下时,为了缓解电阻-电容(RC)延迟导致的铜(Cu) 互连器件可靠性差的问题,急需寻找新的阻挡层材料。与钽(Ta)相比,钴(Co)具有更低的电阻率、更小的硬度、与Cu 更好的粘附性、在高纵横比沟槽中能实现保形沉积等优点。因此,Co 成为取代Ta 的有前途的衬里材料而被堆叠在氮化钽(TaN)阻挡层上。Co 的引入可以降低阻挡层厚度和简化工艺过程。
然而,当技术节点降低至10 nm 及以下时,金属线宽度接近甚至小于Cu 的电子平均自由程。由于侧壁和晶界处电子散射的增加,Cu 的电阻率,开始急剧增加。与Cu 相比,Co 的电子平均自由程更低且可以在阻挡层更薄的情况下工作。因此,Co 成为替代中段制程(MOL)中接触金属W 和后段制程(BEOL)中互连金属Cu 的绝佳候选材料。
Co 的引入势必需要与化学机械抛光(CMP)以及CMP 后清洗等相兼容的工艺。然而,与多层Cu 互连Co 基阻挡层CMP 以及Co 互连CMP 相兼容的抛光液作为商业机密一直未被公开。同时,学术界对Co 的CMP 也缺乏系统而全面的研究。本文就Co 作为Cu 互连阻挡层和互连金属的有效性及可行性进行了系统论述,重点综述了Co 基阻挡层和Co 互连CMP 的研究现状,讨论了不同化学添加剂对材料去除速率、腐蚀防护、电偶腐蚀和去除速率选择性的影响。同时,本文对Co CMP 所面临的问题与挑战进行了总结,以期为Co 基阻挡层以及Co 互连CMP 浆料的开发提供有价值的参考。
集成电路(IC)技术的飞速发展伴随着晶体管几何尺寸和互连金属尺寸的不断微缩。因此,芯片集成度不断攀升的同时,其性能更优越、功耗更低。然而,芯片集成度的增加会使互连金属线(Interconnect)更长、更窄,且电阻更高。因此,在180 nm 技术节点中,IBM 将铝(Al)互连替换为铜(Cu)互连,因为Cu 电阻率更低,其可扩展性更高,可承载的电流密度也更高。然而,Cu 原子相较于Al 原子更容易扩散到介质中而使器件线路短路。因此,氮化钽(TaN)通常与钽(Ta)结合使用,作为Cu 的扩散阻挡层以及Cu 和介质之间的粘合促进剂。
随着半导体制程推进至32 nm 及以下时,不但金属互连层数显著增加,而且导线之间的距离及其自身尺寸缩小。其中,金属线电阻为Cu 线电阻与Ta/ TaN 双层电阻的总和。然而,随着互连线尺寸的不断缩放,用于Cu 互连的高电阻率的Ta/ TaN 双层的厚度基本保持不变。其原因是将厚度仅有几纳米的阻挡层材料继续减薄的技术难度大,且不利于应对Cu扩散带来的器件可靠性差的问题。因此,随着导线尺寸的缩放,Ta/ TaN 双层相对于Cu 互连横截面积的占比越来越大。
换言之,随着高电阻率Ta/ TaN 双层在互连线中占比的增加,它甚至开始主导导线本身的电阻率。因此,由RC 时间常数引起的互连延迟迅速成为制约半导体元件速度或性能的因素。为了解决技术节点缩放带来的互连线整体电阻增加的问题,寻求新的阻挡层材料不失为一个良方。研究表明,Co 材料的引入可以起到降低阻挡层厚度和简化工艺过程的双重作用,其与Ta 相比有许多优点,如电阻率更低、硬度更小、与Cu 的粘附性更好、在高纵横比沟槽中实现保形沉积等。
随着Cu 互连线宽度的持续收缩,Ta/ TaN 双层很难在已有的几纳米的厚度上继续减薄。此外,Cu 的平均自由程λ约为40 nm,因此当Cu 互连线尺寸接近40 nm 时,Cu 电子在侧壁和晶粒边界处的散射增加,过多的电子散射会显著增加Cu 的电阻率。当技术节点降低至10 nm 以下时,Co 被认为是替代Cu 的有前景的新一代互连材料,甚至取代了钨(W)成为填充接触窗(Contact)的主要候选金属 。
新型Co/ TaN 阻挡双层的集成以及金属Co 对Cu 互连的取代等一系列技术创新与CMP 技术的实施密不可分。这主要是因为在IC 制造中,为了实现数以几十亿计晶体管的协同工作,需要多层互连金属之间的连接作用。而为了实现多层金属互连不受下一层表面形貌影响的问题,需要每层表面实现超平坦化。因此,CMP 成为0. 35 μm 及以下技术节点的主流工艺。图1 展示了经各道CMP 工序处理后的超大规模集成(VLSI)电路的3D 示意图。
然而,Co 的显著缺点是在CMP 过程中容易被抛光浆料腐蚀,而过多的Co 损耗会严重影响器件的可靠性。因此,业界人士为了开发出具有优异Co 阻挡层或Co 互连线相容性的新一代CMP 浆料配方展开了大量的研究,以便于将这种金属成功集成到先进的芯片制造中。本文对Co 作为Cu 互连阻挡层材料的有效性和10 nm 以下技术节点Cu 互连的有效替代者的可行性进行了回顾性分析,并对Co 阻挡层和Co互连抛光浆料的研究进展以及存在的问题等进行了逐一的分析和讨论。
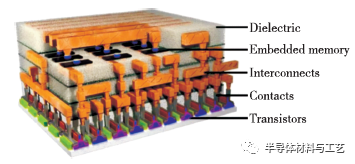
图1 超大规模集成电路3D 示意图
1 多层Cu 互连Co 基阻挡层CMP
1. 1 Co 作为Cu 互连阻挡层材料的有效性研究
随着后段制程中互连线尺寸的不断缩小,传统的双大马士革Cu 集成面临巨大的挑战。这主要是由于在日益狭窄的沟槽和通孔中形成连续的、对称的、保形的溅射Cu 籽晶层变得越来越困难[12,14] 。一方面,Cu 线尺寸的缩小导致Ta/TaN 层贡献的电阻比例不可忽略,这主要是由于金属线上的电阻为Cu 线电阻与Ta/ TaN 双层电阻的总和。Cu 线尺寸较大时,Ta/ TaN 双层引起的电阻增加可忽略不计。但是当芯片微缩到非常小,促使Cu 线的尺寸也逐渐缩小时,Ta/ TaN双层贡献的电阻值可能占据主导地位。宜特材料分析实验室使用并联电阻简化计算的TaN 层电阻贡献度如表1 所示。
另一方面,在进行Cu 电镀之前至少需要30 ~40 nm 的Cu 籽晶层,其厚度甚至超过了精细结构中金属线条的宽度[8] 。经研究发现,将金属Co 引入到Cu 与TaN 之间可以作为二者强有力的粘附剂,可在降低阻挡层厚度的同时降低阻挡层的电阻,可谓是一举两得。
表1 并联电阻简化计算的TaN 层电阻贡献度

2010 年,Huang 等[22] 指出,器件特征尺寸的剧烈收缩使得连续的Cu 籽晶层难以在Ta(N) 阻挡层上形成,从而导致Cu互连处形成空洞,进而诱发器件的断路失效问题,如图2 所示。经研究发现,Co 可以作为增强层而改善阻挡层上Cu 的润湿性和良好的间隙填充性。通过使用Co 增强层,可以获得更好的Cu 互连质量,且不会牺牲线电阻,并提高了器件的可靠性;更重要的是,可在没有Cu 籽晶层的Co 粘附层上直接进行电镀,这将会进一步扩大间隙填充窗口,如图3 所示。

图2 内部Cu 籽晶不足导致孔洞的形成[22]

图3 直接在无铜籽晶的钴增强层上进行电镀后的FIB 图像
2011 年,Jung 等[23] 的研究表明,在32 nm 节点中CVDCo 膜可作为V1/ M2 结构中常规PVD TaN/ Ta 的替代阻挡层。由图4 分别可见,使用TaN/ Co 阻挡叠层代替TaN/ Ta时,线电阻降低约10%,这可能归因于较薄的阻挡层和相应增加的Cu 体积;当应用TaN/ Co 叠层时,也观察到RC 值降低了约10%;无论TaN/ Ta 厚度如何,TaN/ Co 组的所有失效时间(TTF)都比TaN/ Ta 长三倍。
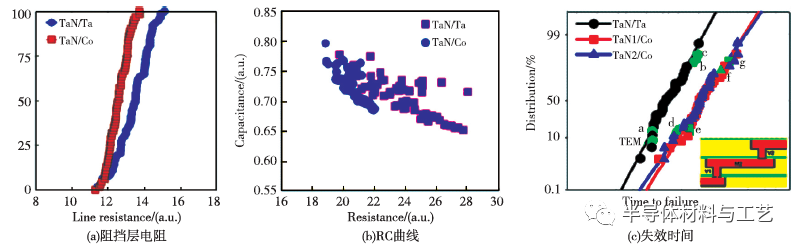
图4 Co 作为Ta 粘附层替代品的优越性[23]
2013 年Xu 等[24] 报道了在无其他添加剂的碱性CuSO4和乙二胺(En)镀液中,在超薄Co 附着层上直接电镀Cu 的电化学过程和成核机理。结果表明,均匀的Cu 籽晶层可以成功地电镀在图形化晶圆的10 nm Co 层上,且电镀的Cu 层具有优先的(111)方向、非常光滑的表面和相对较低的电阻率。他们还将Cu 电镀到厚度约为5 nm 的Co 层上。XTEM结果表明,Co 的厚度损失不明显,如图5 所示。这表明使用碱性Cu-En 电解质系统在超薄Co 层上直接镀Cu 具有巨大的潜力。
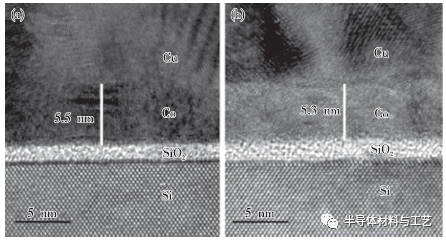
图5 样品的XTEM 图:(a)Si 衬底上溅射的Cu/ Co 层,Co 的厚度约为5. 5 nm;(b)Co 表面上电镀的Cu 层,原始溅射的Co 层为5. 5 nm,最终的Co 层约为5. 3 nm[24]
2013 年,He 等[25] 指出成功的ECP 间隙填充包括两个方面:一是要求沉积阻挡层/ 衬里/ 种子(B/ L/ S)叠层后具有足够的顶部开口尺寸(Dgap);二是要求在沟槽/ 通孔侧壁表面具有足够的PVD Cu 籽晶覆盖率,通常要求Cu 籽晶厚度(Tside )大于3 nm,如图6 所示。他们证实Cu 在Co 上的附着系数比在Ta 上的高。由图7 可知,当沉积时间为2. 8 s 时,与Ta 相比,在Co 表面沉积的Cu 多40%。当沉积时间逐渐延长时,两个衬里表面都被Cu 充分覆盖,因此与在Co 或Ta 上形成Cu 相比,进入的Cu+与衬底表面之间更多是Cu 与Cu 之间的相互作用,与下面的衬里材料无关。此外,由图8a、b 可知,采用回流Cu 籽晶工艺后,带有Co 衬里的Cu 间隙填充没有显示出CMP 后的空洞缺陷,而带有Ta 衬里的晶片在Cu 间隙填充后显示出CMP 后的Cu 空隙;由图8c、d 可知,与采用Ta 衬里相比,Co 衬里的回流Cu 籽晶表现出更均匀的Cu 籽晶分布,在线端区域没有任何孔洞存在。
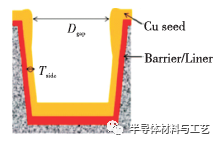
图6 阻挡/ 衬里和溅射的铜籽晶沉积之后的互连沟槽结构的横截面示
意图[25]
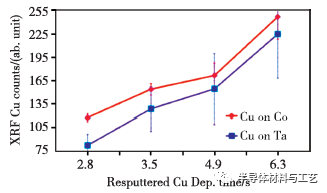
图7 图形片测试:XRF Cu 在Co 和Ta 衬里上的计数与Cu 再溅射时间的关系图[25]

图8 CMP 后使用(a) Co 衬里和(b) Ta 衬里的回流铜籽晶自顶向下的SEM 图;B/ L/ S 沉积后使用(c) Co 衬里和(d) Ta 衬里的回流铜籽晶自顶向下的SEM 图[25
而在Ta 上采用回流工艺后,一些沟槽中心已被Cu 填满,在线端边缘留下小的空腔,如红色圈出部分。因此,对于Co 衬里,再溅射的Cu 籽晶在线端区域更厚且更连续,这主要得益于Co 的高粘附系数和好的润湿性。
综上所述,特征尺寸缩放到32 nm 及以下时,Co 可成为多层Cu 互连中取代Ta 阻挡衬里材料的有效候选材料。Co的引入可以起到降低阻挡层厚度和简化工艺过程的双重作用。这主要得益于Co 优异的物理和化学特性,如低电阻率、低硬度、高粘附系数和较好的润湿性,更重要的是Co 拥有在高纵横比沟槽中实现保形沉积的能力。但是,新材料Co 的引入要求与CMP 以及CMP 后清洁等工艺相兼容。因此,需要进行系统而全面的研究,以筛选出适用于多层Cu 互连Co基阻挡层CMP 的浆料。
1. 2 Co 阻挡层CMP 的研究进展及存在的问题
Co 的CMP 报道始于2010 年。其中,Nishizawa 等[26] 就CMP 浆料对Co 膜腐蚀和抛光性能的影响进行了汇报。结果表明,Co 的腐蚀速率和抛光速率严重依赖于溶液的pH 值。在酸性抛光液中,Co 具有较高的腐蚀及去除速率。他们认为,采用pH 为10 的双氧水、柠檬酸、BTA 的混合浆料体系可获得最佳的Cu/ Co 去除速率(RR)选择性,且该pH 下Cu/ Co之间的腐蚀电位差几乎为零,可以在很大程度上抑制Cu/ Co电偶腐蚀的发生。同年Heylen 等[27] 为了提高CMP 工艺和CVD Co 衬里的兼容性,进行了一系列基础研究,着眼于金属静态蚀刻速率和相关电化学测量的问题。他们指出带有CVD Co 衬里的互连线显示出两种类型的腐蚀问题:其一,电偶腐蚀问题(即沟槽顶部的曲面);其二,沿沟槽侧壁Co 衬里本身的化学腐蚀(即溶解)问题,具体详见图9。此外,他们还指出应该避免使用高过氧化物浓度的酸性浆液来抛光带有CVD Co 金属衬里的窄互连结构,该类型的浆料会加剧Co的腐蚀问题,这与Nishizawa 等的研究结果高度一致。
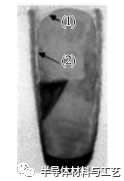
图9 带有Ta(N) / Co 阻挡层的Cu 线在CMP 后的TEM 图:(1)电偶和(2)化学腐蚀问题,2012 年Peethala 等[13] 研究了H2 O2 对Cu 和Co 开路电位(Eoc)的影响,发现pH=10 时,加入1%H2 O2(质量分数,下同)可以显著降低Co 的腐蚀电流密度及减少Cu/ Co 之间电偶腐蚀的发生。此外,Co 的RR 和溶解速率(DR)均随着pH值的升高而降低,这主要得益于高pH 值可以促进Co 表面钝化膜的生成。随后他们发现在pH=10 下抛光的Co 表面粗糙度低于pH 为2 和6 的情况,而且在pH = 10 的情况下,1%H2 O2 +3%SiO2 的浆料中Co 的RR 可忽略不计,且抛光后的Co 薄膜表面未见蚀坑。然后加入0. 5% 的精氨酸可将Co的RR 提高到合理数值,而此时Cu 的RR 和DR 却变得相当高。因此,引入BTA 作为抑制剂来协调Cu/ Co 之间的去除速率选择性。研究结果表明,随着BTA 浓度的增加,Cu 的RR显著降低,而Co 的RR 几乎保持不变。由图10 可知,当BTA含量为5 mmol/ L 时,Cu/ Co 之间的去除速率选择比约为0. 8 ∶ 1,且Cu/ Co 之间的Eoc 差值降低为10 mV。因此,该配比下的抛光液可作为Co 阻挡层CMP 的极佳候选者。
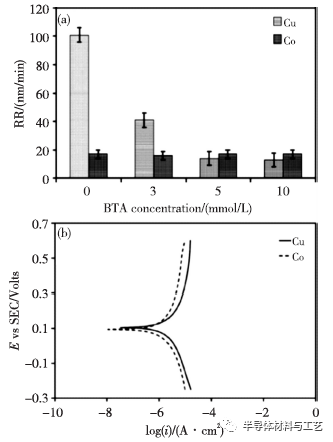
图10 (a) pH=10 下候选浆料中不同浓度的BTA 对Cu/ Co RR 的影
响;(b)候选浆料中Cu/ Co 的动电位极化曲线[13
2012 年,Lu 等[28] 研究了酸性体系下甘氨酸和BTA 对Co的腐蚀和抛光性能的影响。他们指出甘氨酸可以增加Co 的腐蚀速率,不含H2 O2 时,BTA 通过物理和化学作用吸附在Co 上延缓其腐蚀;含H2 O2 时,BTA 和Co2+ 螯合形成不溶的络合物吸附在Co 表面上,从而降低Co 的RR 和静态腐蚀速率(SER),但缺点是需要额外的CMP 后清洗。同年,Lu等[29] 还报道了酸性体系下H2 O2 和2-MT 对Co 化学机械抛光的效果,发现H2 O2 可以增强Co 的腐蚀,尤其是酸性情况下Co 的腐蚀电流随着氧化剂浓度的增加而增大。但是Co的SER 和RR 都随着pH 的增加而显著降低。
此外,他们还发现抑制剂2-MT 的加入可以起到抑制Co 腐蚀及降低Cu/ Co 电偶腐蚀的作用,缺点是2-MT 不能与氧化剂H2 O2 共存,其可用作CMP 后清洗中Co 的缓蚀剂。2014 年,Jiang 等[30] 在碱性浆料中研究了H2 O2 和甘氨酸协同作用对Co CMP 的影响,指出Co 的SER 和RR 随着pH 值的增加而逐渐受到抑制,这主要是由于Co 表面形成了致密的、钝化的Co(Ⅱ)和Co(Ⅲ)氧化物。而且在pH=8 的情况下,添加高浓度的H2 O2 可以进一步降低Co 的RR,在该浆料基础上加入0. 1 mol/ L 甘氨酸可以使Co 的去除速率升高一个数量级。但是,高含量的甘氨酸容易使Cu 布线等产生严重的腐蚀缺陷,因此,应该寻找一些更为温和的络合剂。
2017 年Zhang 等[31] 就TAZ 在阻挡层CMP 过程中对Co/ Cu 去除速率选择性和电偶腐蚀的问题进行了报道。实验结果表明,随着TAZ 浓度的增加,Cu 和Co 的SER 均呈下降趋势。Co 的RR 随着TAZ 浓度的增加先上升后下降,而Cu 的RR 呈单调下降的趋势。此外,他们给出了如图11 所示的TAZ 对Cu 和Co 的抑制模型图。由图11 可以发现TAZ的抑制行为存在两种途径:一种是通过TAZ 的N4 位点与金属原子之间的直接相互作用而成膜,另一种是通过1,2,4-TAZ-中的氮原子与金属离子之间的共享电子成键而成膜。
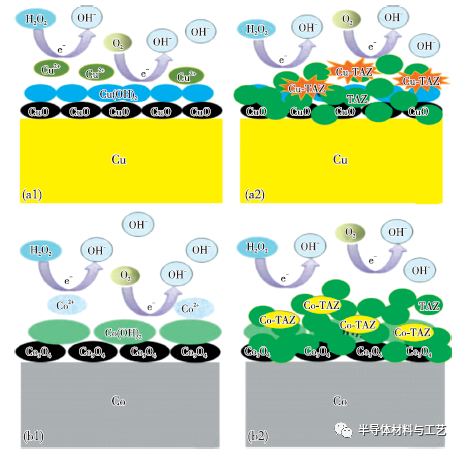
图11 TAZ 对(a)铜和(b)钴的腐蚀机理图:(a1, b1)不含抑制剂;(a2,b2)含抑制剂[31]
2017 年,He 等[32] 用电化学石英晶体微天平(EQCM)研究了不同络合剂和抑制剂对H2 O2 基碱性溶液中Co 腐蚀的影响,发现BTA 和TAZ 可以吸附在Co 的表面上以防止Co腐蚀,而甘氨酸(GLY)、柠檬酸(CA)、抗坏血酸(AA)可促进Co 氧化物/ 氢氧化物的溶解。此外,用零电阻电流计(ZRA)表征了Co-Cu 之间的电偶腐蚀,发现10 mmol/ L 烟酸(NA)和5 mmol/ L TAZ 组合使用可以将电偶腐蚀降到最小值。该文章主要聚焦于对Co 电化学特性的研究,缺乏不同添加剂对Co 抛光机理的探讨。
2017 年Sagi 等[33] 确定了烟酸在含或不含草酸(OA)的pH 为10 的含H2 O2 水溶液中作为Co 膜溶解抑制剂的有用性。他们指出,烟酸会与钴表面的氧化物形成Co(Ⅱ)-NA 络合物,通过在pH=10 下形成络合物,可以抑制Co 膜腐蚀。接触角实验证明了吡啶环的存在是导致Co(Ⅱ)-NA 络合物疏水的主要原因。实验结果还表明,pH=10 时,包含1% 的H2 O2 、40 mmol/ L OA 和80 mmol/ L NA 的水溶液可有效地最小化Co膜的溶解和腐蚀电流以及Co、Cu 的电偶腐蚀。此外,在上述混合物中添加3%的二氧化硅磨料,在2 psi 的抛光压力下,Co和Cu 的RR 分别约为17 nm/ min 和20 nm/ min,即速率选择性良好。
2018 年Johnson 等[34] 用摩擦电化学(动态电化学)的方法设计和评估了用于Co-Cu CMP 系统的碱性浆料。与以往的实验相比,该文引入了大量的动态电化学实验。给出了动态电化学装置使用的诸多细节和理论分析方法。与静态电化学相比,动态电化学更加贴近实际的抛光条件。作者通过显示固定金属样品(静态条件下)获得的结果如何导致有关电偶腐蚀速率的误导性结论,证明了在这些测量中加入摩擦控制的必要性。同时,该研究为14 nm 及以下技术节点Co作为阻挡衬里层的CMP 浆料的开发提供了理论指导和实践探索。
2019 年He 等[35] 系统地研究了腐蚀抑制剂TAZ 对Co 化学腐蚀、Cu/ Co 电偶腐蚀以及H2 O2 基酸性浆料中Co 抛光性能的影响。实验结果表明,5 mmol/ L TAZ 在保证Co 静态腐蚀速率很低的同时可以满足Cu/ Co 去除速率选择比近似1 ∶ 1 的要求,适用于Cu 互连Co 基阻挡层的抛光。有趣的是,当TAZ 为100 mmol/ L 时,Cu 和Co 的去除速率均明显增加,这主要是由于过多的TAZ 会导致形成可溶的Co-TAZ 络合物和不稳定的Cu-TAZ/ Cu 氧化物钝化层。此外,通过相关电化学实验计算发现,TAZ 在Co 表面的吸附符合Langmuir等温线吸附模型,且TAZ 分子化学吸附和物理吸附(主要是物理吸附)共存于Co 表面。
2019 年Yang 等[36] 报道了BTA 和1-苯基-3-甲基-5-吡唑啉酮(PMP)结合使用对Co 电偶腐蚀和点蚀的影响。他们指出Co 表面点蚀的产生严重依赖于H2 O2 的浓度。即溶液中存在少量的H2 O2 时,钝化薄膜由于羟基自由基的侵蚀而破裂,相反,随着H2 O2 含量的增加,钝化薄膜变得更厚、更致密,从而显著抑制了点蚀。随后,他们研究了BTA 对Co 的腐蚀抑制效果,发现BTA 不能有效降低Co 表面的蚀坑。此外,他们还研究了PMP 对Co 腐蚀抑制的效果,发现PMP 不是Co的有效缓蚀剂,仅可用于减少Co 表面的蚀坑。然而,当PMP和BTA 结合使用时,可以很好地抑制Co 的点蚀和Cu/ Co 电偶腐蚀的发生。其不足之处是缺少抛光实验验证,成分配比是否满足抛光实验要求还有待进一步探讨。
2019 年Hu 等[37] 引入了一种新型Cu 缓蚀剂,即TTLYK。他们使用各种分析技术(原子力显微镜、扫描电子显微镜、原位电化学、电化学阻抗谱和XPS 测量等)阐明了TTLYK对Cu 的缓释机理,不足之处是对Co 腐蚀抑制的研究较少,仅展示了少量的Cu/ Co 电偶腐蚀实验。重要的是他们对比了动态电化学和静态电化学的差异性。实验结果表明,与静态情况相比,动态情况下Cu/ Co 之间的电偶腐蚀得到了明显的抑制。因此,他们指出仅进行静态电化学实验,结果将具有相当大的误导性,这清楚地证明了在CMP 浆料的电化学研究中包括动态效应的重要性。同年,Hu 等[38] 首次系统地报道了如何借用正交试验的方法进行Co 浆料的初步筛选。在此基础上,他们通过原位电化学和抛光实验等手段研究了SiO2(磨料)、H2 O2(双氧水)、酒石酸钾(络合剂,简写为PT)和TT-LYK(抑制剂)对Co RR 的影响。这是PT 作为Co阻挡层CMP 络合剂的有效性的首次报道。此外,研究表明,PT 作为络合剂存在于浆液中,既可以支持低压抛光以避免对底层介质的机械损伤,也可以避免强碱性浆液对低k 材料的化学损伤。最后,经过一系列的单因素实验发现在pH = 9时,含有5%SiO2 、1%H2 O2 和1. 2%PT 和900 ppm TT-LYK 的碱性浆料对Cu/ Co/ TaN 的RR 分别约为197. 5 Å/ min、207. 7 Å/ min 和750 Å/ min,即选择比接近1 ∶ 1 ∶ 3. 6,这将最大程度地降低Cu 碟形坑产生的可能性。该浆料配方下,Cu/ Co 之间的腐蚀电位差(△Ecorr)在动态条件下可忽略不计,这表明Cu 和Co 之间发生电偶腐蚀的可能性很小。因此,该配比下的抛光液是Co 基阻挡层CMP 的极佳候选浆料。
2020 年Hu 等[39] 报道了羟基乙叉二膦酸(HEDP)可作为多层Cu 互联Co 基阻挡层CMP 的络合剂。HEDP 作为磷酸类阻垢缓蚀剂,能与铁、铜、锌等多种金属离子形成稳定的络合物,可溶解金属表面的氧化物,起到很好的络合作用;即使在250 ℃的高温情况下,也不会影响它的络合能力,而且在高pH 环境下能保持自身的稳定性。此研究的新颖之处还在于他们采用单频EIS 的方法,对Co 表面的钝化状态进行了实时监测,侧面反映了HEDP 对Co 的络合能力。此外,他们给出了如图12 所示的络合机理图。如图12a 所示,当双氧水基浆料中不含HEDP 时,Co 表面覆盖了由CoO、Co(OH)2和Co3 O4 组成的致密且均匀的钝化膜。因此,该情况下Co的RR 很低。如图12b 所示,当双氧水基浆料中含HEDP 时,由Co(OH)2 水解产生的Co2+ 与HEDP 反应生成可溶性[CoHL]-络合物,这一方面削弱了钝化膜的致密性和完整性,另一方面降低了Co(OH)2 向Co3 O4(已知Co3 O4 坚固,紧凑且更加致密)转化的概率。因此,添加HEDP 会增加Co 的RR。

图12 Co 与HEDP 之间的络合机理:(a) 不含HEDP 的浆料;(b) 含HEDP 的浆料
2020 年Hu 等[40] 通过实验和密度泛函理论(DFT)计算的方法证明了TT-LYK 和油酸钾(PO)作为Co 抑制剂的有效性。实验结果表明TT-LYK 和PO 均可有效改善Co 的表面质量,提高待测液体在Co 表面的接触角。由电化学实验结果推算可知TT-LYK 和PO 在Co 表面的吸附分别符合Freundlich和Langmuir 吸附等温线模型,对应的△G0ads 值分别为-24. 8 kJ/ mol 和-32. 6 kJ/ mol,表明两种抑制剂在Co 表面同时存在物理吸附(占主导地位)和化学吸附。另外,实验结果表明,与仅包含TT-LYK 或PO 的溶液相比,即使在每种抑制剂的浓度相对较低的情况下,这两种抑制剂的组合也显著提高了Co 的耐腐蚀性。
他们还提到了一个有趣的现象,即TT-LYK 和PO 对Co的良好抑制作用仅限于静态条件,如可以改善Co 的表面质量(即降低Co 的静态腐蚀速率)、抑制Co 的腐蚀电流。但是,在动态抛光条件下,两种抑制剂的加入均可以增加Co 的去除速率,而且随着PO 浓度的增加,Co 去除速率的增长比使用TT-LYK 的情况更为显著。对于这一现象,他们推测如下:(1)吸附在Co 表面的TT-LYK 和PO 容易被抛光垫机械去除,从而暴露出内部的Co(OH)2 ,然后由Co(OH)2 水解产生的Co2+可能与TT-LYK 或PO 发生络合反应,破坏了Co 表面钝化膜的致密性和完整性,进而提高了Co 的抛光速率;(2)抑制剂的加入抑制了Co(OH)2 向更加致密且难以去除的Co3 O4 的转化;(3)与TT-LYK 相比,由Co(OH)2 水解产生的Co2+ 与PO 的结合力更强。因此,在动态抛光下,PO 在一定程度上显示出比TT-LYK 更强的络合能力。
2020 年Zhang 等[41] 通过实验和DFT 计算研究了次氮基三乙酸(NTA)和缓蚀剂TT-LYK 对Co 阻挡层化学机械抛光的影响。实验结果表明,NTA 是Co 的有效络合剂,这主要是由于NTA 可以与Co(OH)2 水解产生的Co2+ 发生络合反应。DFT 计算结果表明,TT-LYK 分子可以通过原子N9、N10 和O17-H··Co 氢键垂直吸附于Co 的表面,以及可以通过苯和三唑环平行吸附于Co 的表面,如图13 所示。TT-LYK 和NTA 的结合可以提高抛光后Co 表面的质量,这主要是由于NTA 的络合作用提高了Co 表面凸起区域中氧化膜的去除率,而TT-LYK 在凹陷区域中的吸附抑制了化学溶解,最终实现了全局平坦化。
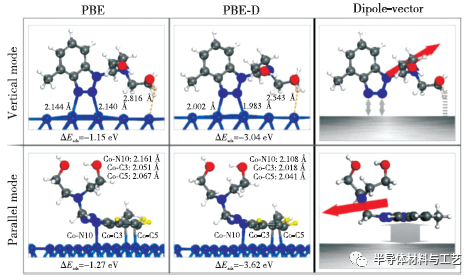
图13 使用PBE 功能(左图)和PBE-D 功能(中图)在Co(0001)表面上优化了垂直和平行吸附构型;沿吸附态方向绘制的分子偶极向量(右图)[41]
2020 年Zhang 等[42] 深入研究了Cu 互连Co 基阻挡层CMP 过程中,采用过硫酸钾(K2 S2 O8 )作为浆料中的氧化剂时Co 表面的化学形成和力学性能。他们指出,与H2 O2 相比,K2 S2 O8 的氧化能力更强,可以显著提高Co 的RR,这主要得益于活性硫酸盐自由基的强氧化能力。此外,他们指出含K2 S2 O8 的浆料使Cu 和Co 膜展现出优异的蚀刻后形态以及更少的颗粒污染。因此,氧化剂K2 S2 O8 适用于Cu 互连Co基阻挡层的平坦化。研究表明在pH 为10 时,含3% 硅溶胶(体积分数)、5 mmol/ L BTA、10 mmol/ L K2 S2 O8 的抛光浆料中Cu 和Co 的去除速率选择比约为1。他们的研究未涉及TaN、TEOS、BD 等材料的去除速率。因此,相关浆料是否具备成熟抛光液的功能尚不明确。
综上所述,Co 具备降低阻挡层厚度和简化工艺过程的双重作用,由此成为取代Ta 的有前途的衬里材料,在实际应用中可被堆叠在TaN 阻挡层上。为了开发出与Co 基阻挡层CMP 相兼容的抛光液,学者们开展了大量研究,其主要技术难点及亟待解决的问题为:Co 在抛光液中的腐蚀问题严重且腐蚀抑制难度大,迫切需要寻找Co 的高效抑制剂;溶液中,Cu/ Co 之间极容易诱发电偶腐蚀而降低器件的可靠性,因此寻找抑制电偶腐蚀发生的缓蚀剂至关重要;在阻挡层CMP时,Cu/ Co/ TaN/ TEOS 等多种材料之间的去除速率选择性难以协调,不利于碟形坑(Dishing)和蚀坑(Erosion)的控制,缺乏系统而全面的机理研究。
2 Co 互连CMP
2. 1 Co 互连的可行性分析
当技术节点降低至10 nm 及以下时,金属线宽度接近甚至小于Cu 的电子平均自由程,线电阻不再随导线尺寸线性变化。相反,由于侧壁和晶界处电子散射的增加以及难以按比例缩放现有阻挡层/ 衬层厚度而导致Cu 占比降低,Cu 电阻率开始急剧增加[25] ,如图14 所示。此时,互连电路内RC延迟将急剧增加,这将导致电路运行速度降低、能耗更大、散热也更复杂,对低功率器件来说并不理想。换句话说,尽管有更高性能的晶体管,但后段的布线技术无法与之匹配。Cu布线的匹配问题已成为一个难以突破的瓶颈。另一方面,相较于Cu 互连材料,Co 金属的电子平均自由程更低(尽管电阻率相对较高),如表2 所示[43] 。电子平均自由程定义了电子在无散射的情况下在体材料中传播的长度。更小的电子平均自由路径允许电子以更少的碰撞通过窄线,从而产生更低的电流电阻。此外,与Cu 相比,Co 可以在阻挡层更薄的情况下工作[44] 。基于这些原因,Co 有助于在10 nm 及以下制造节点替换MOL 中的W 和BEOL 中的Cu,从而释放晶体管的全部潜力。
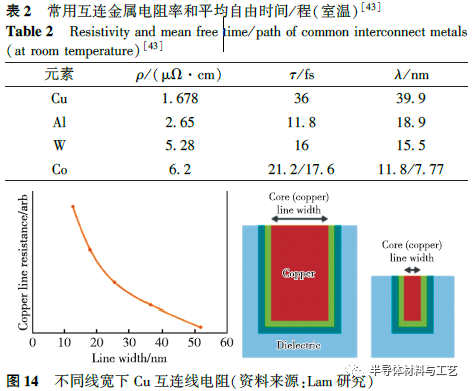
2016 年Kamineni 等[45] 指出使用基于CVD 的Co 来代替广泛使用的W,以用于10 nm 和更小的节点的局部互连。他们强调Co 金属化的可行性主要得益于三个优点:(1)CVDCo 前驱物不会损坏Ti 衬里;(2)Co 不需要高电阻率的成核层,从而为块状金属提供了更多的空间;(3)它可以实现高纵横比的无空隙填充而没有缺陷,这是常规PVD 工艺难以实现的。图15a 中显示了Co 局部互连层(CA)的无空隙和无缝填充。图15b 显示了Co CMP 后没有中空金属缺陷。此外,图16 显示了在局部互连水平上从基于W 的金属化转变为基于Co 的金属化所带来的线电阻收益。由图16 可知,约2. 5倍的线电阻减少可归因于TiN 阻挡层的缩放(从30 Å 到20Å)和Co 金属化。
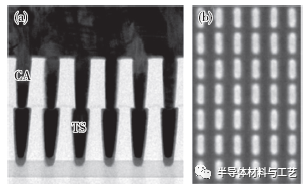
图15 (a)钴填充的MOL 局部互连层的横截面TEM 显微照片;(b) CoCMP 后的SEM 检查图
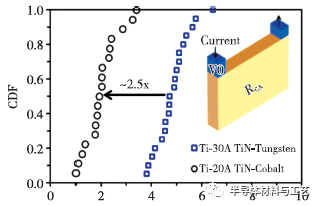
图16 CA 线电阻的累积分布图
2016 年Kelly 等[46] 在10 nm 节点集成的双镶嵌测试载体中,将Co 评为替代Cu 金属布线的绝佳候选材料。如图17所示,在双镶嵌结构中Co 填充完好无缺,且在介质中没有明显的Co。他们指出在5 nm 及以下技术节点时,Cu 线电阻可能会比Co 线电阻低。但是,也有人指出,在10 nm 及以下技术节点时,Co 是替换BEOL 中Cu 和MOL 中W 的最佳候选材料,如图18 所示,相较于Cu 和W,Co 的电阻在较小的特征尺寸上具有很大的优越性。
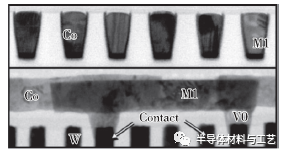
图17 Co 互连(顶部)和通孔链(底部)的横截面TEM 显微图
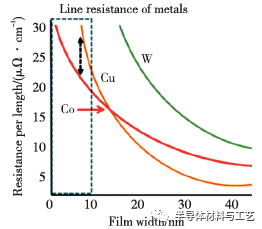
图18 40 nm 线宽以下时W、Cu 和Co 的电阻
尽管Co 在低技术节点上展现出众多优势,但是值得注意的是,Co 并未完全取代Cu 的用途。目前所知Co 仅用于前两个金属层(即M0 和M1),该两层局部互连线的间距非常窄( ~36 nm),而Co 的引入将极大提高器件的性能。而对于更长的距离和更厚的大型互连线,继续使用Cu 线是有意义的。
2. 2 Co 互连CMP 的研究进展及存在问题
2017 年Wu 等[47] 指出,当技术节点发展到10 nm 或更远时,Co 已成为替代MOL 中接触金属W 和BEOL 中互连金属Cu 的绝佳候选材料。据估计, 与对应的W 相比, 用于7 nm 逻辑器件的Co 金属化可以显著降低电阻并提高5% ~7%的性能。研究表明Co 的CMP 涉及如图19 所示的两步:第一步是Co 覆盖层的去除(The Co bulk CMP),要求快速去除Co,并停止在TiN 衬里上。因此,该阶段Co 和TiN 之间的去除速率选择比应高于100 ∶ 1。第二步是阻挡层抛光(TheCo buff CMP),要求快速去除衬里材料(TiN),而Co 和层间介质(ILD)的RR 相对较低。该报道的不足之处是没有公开添加剂的成分,缺乏对抛光实验和电化学机理的解释。

图19 钴CMP 工艺示意图
2017 年Popuri 等[48] 报道了柠檬酸在互连Co 膜的化学机械抛光液中可用作络合剂。实验结果表明抛光液pH 值对DR 和RR 均有显著影响,即随着pH 值和H2 O2 浓度的增加,DR 和RR 均减小;当柠檬酸和H2 O2 同时存在时会显著增加Co 的RR,这主要是由于柠檬酸和钴氧化物之间可以发生络合反应;pH 值为8 时,使用包含3% ~ 10% (质量分数)的二氧化硅、1%(质量分数)的H2 O2 和50 mmol/ L 柠檬酸的分散液可导致相当高的RR(180 ~ 500 nm/ min)和可忽略的DR(0 nm/ min),这使该分散液成为抛光Co 互连线时的理想选择。但是,该浆料不能很好地控制Co-Ti 对之间的电偶腐蚀,即使加入100 mmol/ L 常规抑制剂(如TAZ 和BTA),也无法有效地将Co-Ti 之间的△Ecorr降低至20 mV 以下。因此,需要寻求新的抑制剂。
同年,Popuri 等[49] 对上述抛光浆料进行了再次优化。其中,主要研究了TAZ、N-月桂酰肌氨酸钠盐(NLS)和PO 作为钝化剂在Co 互连CMP 中的应用。实验结果表明,与添加TAZ 和NLS 相比,pH 值为7 时PO 的引入使Co 的腐蚀电流要低1—2 个数量级(1 ~3 μA·cm-2 ),抛光后的表面质量要好得多。因此,PO 是一种较好的用于Co 互连抛光的钝化剂。此外,计算结果表明PO 在Co 表面的吸附符合Langmuir吸附等温线模型。其中,吸附的标准自由能约为-40 kJ/ mol,表明PO 主要以化学形式吸附在Co 的表面。FTIR 和衰减的FTIR 光谱数据表明,PO 与Co 的结合是通过PO 中羧酸基团的负电荷氧与Co 表面的桥接配位而实现的。最终他们确定了两种二氧化硅分散体,其中一种可以大量去除Co(用于第一步抛光),具体成分是3%SiO2(质量分数)+ 1%H2 O2(质量分数)+ 50 mmol/ L 柠檬酸+1 ~2 mmol/ L PO 且pH 值为7;另一种用于Co 互连阻挡层去除(用于第二步抛光),具体成分为3%SiO2(质量分数)+50 mmol/ L 柠檬酸+3 mmol/ L PO 且pH 值为7。
2018 年Tian 等[50] 研究了多胺螯合剂(FA/ O Ⅱ)和氧化剂H2 O2 对Co bulk CMP 的影响。实验结果表明,FA/ O Ⅱ螯合剂与H2 O2 结合可以有效提高Co 的去除率。当pH 值为8的浆料中含有2% (质量分数,下同) 的FA/ O Ⅱ螯合剂和0. 15%的H2 O2 和3%的胶态二氧化硅磨料时,可以达到相当高的去除率( ~5 000 Å/ min),有助于Co 膜的快速去除。此外,XPS 和紫外可见(UV-vis)光谱实验结果表明,Co 的高去除率可能是由于水溶性Co(Ⅲ)-FA/ O Ⅱ络合物的形成。最后,他们指出TT-LYK 的加入可以显著降低Co 的静态腐蚀速率,但不会明显改变Co 的去除速率。该报道的不足之处在于缺少Ti(或者TiN)抛光及其电化学实验的相关研究,缺乏TT-LYK 对Co 抑制机理的相关探讨。
2019 年Ranaweera 等[51] 研究了含过硫酸铵(APS)和PO的二氧化硅分散体对Co 互连CMP 的影响。他们首先研究了pH 值、APS 浓度对Co RR 和DR 的影响。实验结果表明,在所有考虑的pH 值下,添加0. 1%(质量分数)的APS 到3%(质量分数)的二氧化硅浆料中,RR 显著提高。其原因主要有两点:(1)APS 是一种强氧化剂,能够产生更强大的SO4·- ,从而增强Co 的氧化,进而导致更高的RR;(2)研磨和溶解的物质(如钴离子、氢氧化物和氧化物) 可加速Co 表面附近S2 O82-的活化,从而在抛光过程中进一步增加SO4·- 的浓度,进而促进Co 的氧化并提高RR。实验结果还表明,含与不含APS 时,pH 值对RR(或DR)的影响呈现出相似的趋势,即随着pH 值升高,RR(或DR)逐渐降低。这主要是由于碱性环境下较低的H+浓度减少了Co 表面Co(OH)2 钝化层的溶解,另一方面碱性环境下较高浓度的OH- 可以促进Co(OH)2 向更致密、更稳定的Co3 O4 和CoOOH 转化。当pH 为9 的含3%SiO2(质量分数)+1% APS(质量分数)+0. 2 mmol/ L PO 的抛光浆料用于Co 互连CMP 时,Co 的RR 约为465 nm/ min,Co和TiN 之间的RR 选择比大于100 ∶ 1,且Co 和TiN 之间发生电偶腐蚀的可能性极低。
2020 年Cheng 等[52] 研究了PT 在Co “buff step” CMP 过程中作为络合剂时对Co/ TiN/ TEOS 去除速率选择性的影响。实验结果表明,随着pH 值的升高,Co 和TEOS 的RR 逐渐降低,而TiN 的RR 几乎不受影响;随着H2 O2 浓度的增加,TiN的RR 升高,Co 的RR 先升高后降低,而TEOS 的RR 几乎不受影响;Co、TiN 和TEOS 的RR 均随着PT 浓度的增加而增加。他们着重分析了PT 对TEOS 和Co 的络合机理,发现PT 的加入可以提高二氧化硅磨料与TEOS 表面之间的吸引力,使得机械力增加,因此TEOS 的RR 增大。此外,Co 表面Co(OH)2 水解产生的Co2+会与PT 形成可溶性络合物,这可以在很大程度上提高Co 的RR。所述浆料均不含抑制剂,静态腐蚀后镀膜片的表面质量是否符合实验要求需要进一步求证。
综上所述,Co 由于具有优异的物理、化学特性而成为10 nm 及以下技术节点替代MOL 中W 和BEOL 中Cu 的有效候选材料。Co 作为新型互连材料近几年才兴起,与之相关的CMP 文献报道较少。主要技术难点及亟待解决的问题总结如下:Co 的易腐蚀特性不利于Co 互连CMP 中碟形坑的最小化,导致不利于获得理想的平坦化效果;Co/ Ti 电偶腐蚀的发生会降低互连线的电气和机械完整性,因此寻找能控制Co化学腐蚀和Co/ Ti 电偶腐蚀的缓蚀剂至关重要;Co 作为互连材料时,无论是‘bulk'CMP 还是‘buff'CMP,异质材料之间的去除速率选择性难以控制,需要进行更深入的研究和探讨。
3 结语与展望
Co 由于具有更低的电阻率、更小的硬度、与Cu 更好的粘附性和在高纵横比沟槽中能实现保形沉积等诸多优点,而被广泛用作Cu 互连阻挡衬里材料以取代Ta。此外,10 nm及以下技术节点时,Co 成为替代MOL 中接触金属W 和BEOL中互连金属Cu 的绝佳候选材料。因此,与Co 基阻挡层CMP 以及Co 互连CMP 相兼容的抛光液的开发受到业界和学术界的广泛关注。
十年来,多层Cu 互连Co 基阻挡层CMP 所面临的主要挑战与解决方法总结如下:(1)由于自身活泼性决定,Co 在很宽的pH 范围内容易发生腐蚀。为此,解决方法一般为提高浆液pH 值、提高过氧化氢浓度、添加抑制剂(如BTA、MBTA、TAZ、TT-LYK、NA、PO 等)。(2)由于Co 和Cu 的标准还原电位分别为-0. 28 V 和0. 34 V,两种材料在浆料中接触时,极容易诱发电偶腐蚀,而Co 作为阳极会被加速腐蚀。解决方法无外乎三种:①提高Co 的电位,一般是通过提高溶液pH 值、提高双氧水浓度、引入抑制剂;②降低Cu 的电位,如添加络合剂等;③提高Co 电位的同时降低Cu 的电位,这需要不断协调多种添加剂,是一个耗时费力的过程。(3)阻挡层CMP 时,Cu/ Co 等多种材料之间的去除速率选择性难以控制,不利于Dishing 和Erosion 的修正。通常需要在浆料中添加抑制剂和活性剂等化学成分,对浆料进行反复优化。(4)现有文献大多集中于对某一种或两种材料的研究,而实际的阻挡层CMP 涉及多种材料,因此,多种材料之间的抛光机理探索应是未来的重点。
Co 接触/ 互连CMP 的研究近几年才兴起。仅有的几篇文献研究多集中于Co 的第一步抛光。就目前的研究成果来看,未来Co 互连CMP 浆料的开发应在如下几个方面进行深入探讨:(1)弱碱性pH 下Co 的腐蚀抑制问题。由于强碱性浆料不利于Co 第一步CMP 过程中的快速去除以及酸性浆料存在严重腐蚀设备和互连材料的问题,文献大多将抛光液的pH 定为弱碱性区域,而弱碱性环境下Co 的腐蚀抑制研究有助于浆料的开发。(2)Co 与Ti 或TiN 之间的电偶腐蚀问题。Popuri 等指出双氧水体系下,Co 与Ti 之间的电偶腐蚀难以控制,因此,需要尝试更多新的化学添加剂以筛选出符合需要的CMP 浆料。(3)Co 互连阻挡层CMP 期间多种材料之间的去除速率选择比问题。选择性的好坏直接影响抛光后材料的表面良率,而不同材料涉及的抛光机理和电化学特性应该是未来研究的重点。
声明:本文由半导体材料与工艺转载,仅为了传达一种观点,并不代表对该观点的赞同或支持,若有侵权请联系小编,我们将及时处理,谢谢。







